台积电|台积电先进封装再下一城,博通设计特斯拉HPC将投7纳米
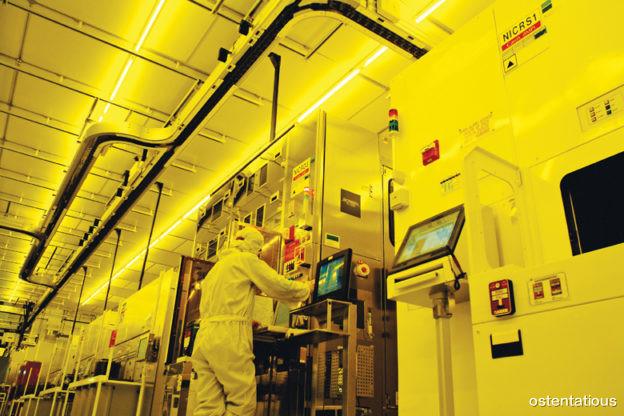
业界传出 , 台积电又再拿下大单 , 将代工博通与特斯拉共同研发的高效能运算芯片 。
消息指出 , 此单将会以台积电7纳米制程投片 , 且值得注意的是 , 将采用台积电InFO等级的系统单晶圆(System-on-Wafer , SoW)技术 , 能将HPC芯片在不需要基板及PCB情况下直接与散热模组整合成单一封装 , 是今年才刚量产的最新技术 。 此案预计第四季开始生产 , 初期将先投约2000片 。
针对HPC基板上晶圆上晶片封装制程(CoWoS) , 台积电今年已经推出支援5纳米逻辑单芯片及2.5 倍光罩尺寸中介层 , 并可做到5层金属层及深沟槽电晶体的程度 , 最高能搭载6颗HBM2e内存 。 明年还将更进一步 , 做到3倍光罩尺寸中介层 , 并支援搭载最多8 颗内存 。
【台积电|台积电先进封装再下一城,博通设计特斯拉HPC将投7纳米】而这次博通为特斯拉打造的ASIC芯片据传将成为未来新款电动车的核心处理器 , 将用于实现真正自驾能力的重要合作项目 , 每片12寸晶圆约只能切割出25颗芯片而已 , 是利用路线重分布技术将电源等多颗芯片进行联结 , 并直接贴合在散热模组上 , 预期明年第4季将进行大规模量产 。
业界表示 , 虽然目前先进封装技术也是竞争激烈 , 但如三星在晶圆制造上之线宽微缩已落后于台积电 , 整体实力评估 , 可能只有英特尔开发的EMIB先进封装技术能够与之比肩 。 但如今英特尔7纳米制程出现问题 , 且主要仍以IDM为主的情况下 , 无法如台积电一般广泛供应给其他高阶芯片商 , 基本上台积电封装技术应会成为市场主流 。
推荐阅读
- 3道电饭煲版懒人焖饭,饭菜一锅出,满嘴喷香,美味省心~!
- 液态金属|脑科学日报:开发用于活体神经记录的可拉伸液态金属电极阵列
- 1碗面粉2个鸡蛋,教您做电饭锅面包,一看就会,简单好吃零失手
- 整只鸡丢电饭锅里,不放油不加水,出锅香味四溢还流油,比烤鸡香
- 教你1碗面粉4个鸡蛋做蛋糕,不用烤箱不用电饭煲,新手一次成功
- 电休克|电休克用于儿童青少年患者的疗效及安全性|研究简报
- 电饭煲做蛋糕,方法是关键,轻松做出8厘米高度,蓬松暄软又细腻
- 马也|马也会“鸭梨山大”!兽用脑电波判断你的宠物快乐吗?
- 叶片|又创世界纪录,世界最长风电叶片在江苏盐城下线
- 在家自制面包,不用烤箱,电饭锅就搞定,比馒头软,学会不用买了

















